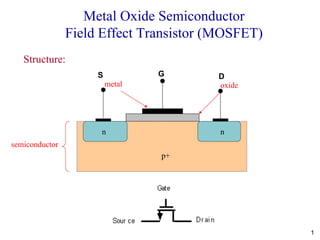
MOSFET Operation and Structure
- 1. 1 Metal Oxide Semiconductor Field Effect Transistor (MOSFET) Structure: metal oxide semiconductor p+ n n S G D
- 2. 2 MOSFET operation p+ n n S G D If VG=0 n Assuming VD=high, VS=0 No current
- 3. 3 p+ n n S G D If VG=high n + + + + An n type channel is formed Now if VD=high, there is a current flow between D and S Gate voltage attracts electrons and pushes holes away MOSFET operation
- 4. 4 MOSFET structures and circuit symbols p- type substr ate Sour ce Dr ai n Gate Substr ate Si O2 Dr ai n Sour ce Sour ce Dr ai n Gate Sour ce Dr ai n Bul k Channel Depl eti on r egi on n + n+ (a) (b) (d)(c) (a) Schematic structure of n-channel MOSFET (NMOS) and circuit symbols for (b) MOSFET, (c) n-channel MOSFET, and (d) n-channel MOSFET when the bulk (substrate) potential has to be specified in a circuit.
- 5. 5 Complementary MOSFET pairs Schematic structure of Complementary MOSFET (CMOS) and circuit symbols for p-channel MOSFET (PMOS). Minuses and pluses show the depletion regions. p- type substr at e n + Sour ce Dr ai n Gate Subst r ate Si O2 Sour ce Dr ai n Gate Sour ce Dr ai n Bul k p + n- channel p- channel n- type wel l Si O2
- 6. 6 Sub-threshold mode of MOSFET operation • VG = 0; the MOSFET conducting channel is not formed Ec EF ²E F1 ²E F2 Channel Source Drain Energy Distance In the subthreshold regime, the MOSFET current is a small reverse current through the source – substrate and drain – substrate p-n junctions; Only a small number of electrons can pass over the potential barrier separating the drain and the source. VG = 0 higher VG ΦB ( / )B kT ST Sourcen n e− Φ ≈ ×
- 7. 7 In the sub-threshold regime, the channel current is very low and increases exponentially with the gate bias. DrainSource VG1 VG2 VG3 VG1<VG2<VG3 Gate-source voltage (V) 1.81.41.00.60.2-0.2 0 -10 -8 -6 10 2 -4 -2 0.05 V V ds = 3.0 V I t10 10 10 10 10 10 Sub-threshold mode of MOSFET operation ( / )B kT ST Sourcen n e− Φ ≈ ×
- 8. 8 At certain gate bias called the threshold voltage, the conductivity type under the gate inverts and the barrier between the Source and the Drain disappears. Electrons can enter the region under the gate to form a conducting n-channel. At the gate voltages above the threshold, the gate and the channel form a Metal-Insulator-Semiconductor (MIS) capacitor. DrainSource VG1 VG2 VG3 VG1<VG2<VG3 Gate-source voltage (V) 1.81.41.00.60.2-0.2 0 -10 -8 -6 10 2 -4 -2 0.05 V V ds = 3.0 V I t10 10 10 10 10 10 MOSFET threshold voltage VT
- 9. 9 The free electron charge in the MOSFET channel (per unit area): Q1 = CGATE × (VG – VT) (assuming that at VG = VT the free electron concentration is zero) MOSFET above the threshold voltage qns = ci VGS − VT( )= ciVGT 0/ /i i i ir ic d dε ε ε= = The sheet electron concentration above the threshold, nS is given by: In MOSFETs, the gate and channel form a MIS-capacitor, hence the capacitance per unit gate area εi = εir ε0 is the total dielectric permittivity of the gate dielectric (usually, SiO2), εir is the relative dielectric permittivity of the gate dielectric. Total gate capacitance CG = ci ×A, where A is the gate area
- 10. 10 Above the threshold, the sheet electron concentration and hence the channel current increase linearly with the gate bias VG. Gate-source voltage (V) 1.81.41.00.60.2-0.2 0 -10 -8 -6 10 2 -4 -2 0.05 V V ds = 3.0 V I t10 10 10 10 10 10 MOSFET above the threshold voltage qns = ci VGS − VT( )= ciVGT
- 11. 11 MOSFET Threshold Voltage semiconductor metal oxide p+ n n S G D DrainSource
- 12. 12 Band Diagram at the MOS interfaces metal oxide p+ n n Before Contact EC EV EFs Ei Vacuum level OXIDEMETAL SEMICONDUCTOR EFm EC EV qφm Eg q χox q χsq χs qφs
- 13. 13 p+ n n After Contact OXIDEMETAL SEMICONDUCTOR EC EV EFs Ei EFm EC EV EC EV EFs Ei EFm EC EV Metal and semiconductor Fermi levels align by electron transfer. Bending is the result of the presence of transferred electron
- 14. 14 VG>0 p + n n VG EC EV EFs Ei EFm EC EV VG VG<VFB EC EV EFs Ei EFm EC EV VG VG=VFB EC EV EFs Ei EFm EC EV VG Flat band Voltage Gate voltage making the band flat VFB= φm-φs
- 15. 15 Conductivity conversion in MOSFET EC EV EFs Ei VG=0 p + VG n n EC EV EFs Ei VG ↑ p + VG n n Less holes at the interface, more bending p typeLess p type More depletion
- 16. 16 EC EV EFs Ei VG ↑ ↑ p + VG n n p typeLess p type n type Inversion EC EV EFs Ei VG ↑ ↑ ↑ p + VG n n p typeLess p type n type Strong Inversion Onset of Channel creation Channel created
- 17. 17 Inversion condition in MOSFET EC EV EFs Ei qφb qVs Surface potential Vs is controlled by the gate voltage Accumulation Vs<0 Depletion Vs<φb Onset of inversion Vs=φb Inversion Vs>φb Strong Inversion Vs>2φb bq kT ip n e φ = Equilibrium hole concentration in the bulk of semiconductor qφb is the Fermi level offset from the mid-gap in the bulk material When Vs = 2φb, n-concentration at the surface is the same as p-concentration in the bulk
- 18. 18 Surface potential required to reach the MOSFET threshold When Vs = 2φb, n-concentration at the surface is the same as p-concentration in the bulk bq kT ip n e φ = EC EV EFs Ei VsT=2φb φb φb bq kT in n e φ =
- 19. 19 Surface potential and gate voltage EC EV EFs Ei EFm EC EV VG Vi Vs • VG is the gate voltage, as source is grounded, VG=VGS • Vi is the voltage drop across the oxide/insulator • Vs is the surface potential GS FB s iV V V V= + +
- 20. 20 Voltage drop across the oxide layer EC EV EFs Ei EFm EC EV VG Vi Vs Vi is the voltage drop across the oxide/insulator GS FB s iV V V V= + + d i i Q V C = where Qd is the capacitor charge and Ci is the capacitance. Since the charges on the metal and semiconductor plates are the same, Qd can be calculated as the charge in semiconductor. The semiconductor charge is formed by the charge of the depletion region Gate electrode and semiconductor form the plates of the MOS capacitor. Voltage drop across the capacitor:
- 21. 21 Voltage drop across the oxide layer EC EV EFs Ei EFm EC EV VG Vi Vs The relation between the depletion region width W and the applied voltage Vs: 2d s a sQ qN Vε→ = 2 2 a s s q N W V ε = 2 s a V W qN ε =Form this, 2 s d a a a V Q qN W qN qN ε = = The depletion region charge (per unit area):
- 22. 22 Voltage drop across the oxide layer EC EV EFs Ei EFm EC EV VG Vi Vs d i i Q V c = is the depletion region charge per unit area, ci is the MOS-capacitor capacitance per unit area: sasd VqN2Q,where ε= di is the thickness of the oxide film under the gate i i i c d ε =
- 23. 23 MOSFET threshold voltage (cont.) 2 s a s GS FB s i qN V V V V c ε = + + At the onset of strong inversion: ( ) ( )2 2 2 s a b T FB b i qN V V c ε φ φ= + + 2 2 NT FB b bV V ϕ γ ϕ= + + Finally, the threshold voltage, 2 N s a iqN c/γ ε=where the body effect constant, The MOSFET threshold voltage is defined as the Gate voltage leading to the strong inversion, i.e. Vs = 2φb
- 24. 24 Effect of Body Bias p+ n n VS VG VD VBS ≠0 ( )BSbNbFBT V22VV −ϕγ+ϕ+= the Threshold voltage,
- 25. 25 Effect of Surface States p+ n n VS VG VD VBS ≠0 ( )BSbNb i ss FBT V22 C Q VV −ϕγ+ϕ++= the Threshold voltage, During the oxide growth on Si, dangling bonds are created that contributes to wanted trapped charges at the interface + + + + + + + + + + Qss : surface state charges per unit area